深光谷科技联合亿源通科技推出基于3D光波导技术的多芯MT-FIFO组件方案,助力高密度光互连应用
深圳市深光谷科技有限公司(以下简称“深光谷”)与广东亿源通科技股份有限公司(以下简称“亿源通”)正式达成深度战略合作,联合推出基于3D光波导技术的多芯MT-FIFO组件方案。该方案通过三维光波导结构实现硅光芯片与多芯光纤MT接口之间的高密度光路转换,在保证低损耗与高一致性的同时提升集成度,为下一代高速光模块和AI数据中心互连提供关键支撑
2026.03.17编辑:阅读:867
展会时间:2026年3月17日-19日,
展会地点:洛杉矶会展中心 (Los Angeles Convention Center),
展位号:WEST HALL,#4750
一、3D光波导芯片及其服务
从平面到立体:3D光波导芯片为数据中心光互连带来新突破
随着人工智能、大模型训练以及高性能计算的快速发展,数据中心对带宽密度与互连效率的需求持续攀升。高速光互连技术正从传统光模块架构向更高带宽与更高集成度演进,一方面,光模块速率不断迈向800G、1.6T甚至更高,光纤数量快速增加;另一方面,CPO(Co-Packaged Optics)等新型光电共封装架构正在兴起,对芯片级光互连的密度与集成能力提出了更高要求。在这一趋势下,传统基于二维平面结构的光波导方案在通道密度、空间利用率以及光路灵活性方面逐渐面临瓶颈。
在多芯光纤(MCF)应用场景中,需要在有限空间内实现多通道光信号的高密度耦合与空间重构,而在CPO架构中,则需要在芯片级封装环境中实现复杂光路的灵活布线与高密度集成。相比传统平面光波导结构,3D光波导技术能够在三维空间中构建多层光路,实现不同高度与方向的光信号传输与交叉,大幅提升光通道集成密度与设计自由度。这一技术不仅能够更好地适配多芯光纤的空间耦合需求,也为CPO系统中的高密度光路互连提供了关键支撑,成为下一代数据中心光互连的重要技术路径。
展会展品:3D光波导芯片赋能多芯光纤与CPO应用
在本届OFC 2026展会上,深光谷科技将重点展示其玻璃基3D光波导芯片系列产品,面向多芯光纤互连与CPO(Co-Packaged Optics)两大核心应用场景,为下一代高密度光互连提供关键基础器件。
在多芯光纤应用方向,深光谷科技推出了适配多种多芯光纤结构的3D光波导芯片产品,包括4芯、双4芯以及7芯光波导芯片方案。该系列产品可实现多通道光信号的空间重构与高效耦合,并兼容市场主流光纤厂商的多芯光纤设计方案,为数据中心高密度光纤互连提供灵活、低损耗的光学接口解决方案。
在CPO应用方向,深光谷科技将展示面向高密度PIC(Photonic Integrated Circuit)的扇入/扇出3D光波导芯片。该类芯片可实现光通道在不同间距之间的高精度转换与三维布线,满足CPO光引擎中高通道密度光互连的需求,为光电共封装系统中的光路管理与集成提供关键支撑。

3D光波导芯片系列产品
产品亮点:优异的性能指标和量产能力
依托自主飞秒激光直写3D光波导制造技术,深光谷科技的玻璃基3D光波导芯片可在玻璃内部构建高精度三维光路结构,满足多芯光纤互连及CPO系统对高密度光连接的应用需求。
在性能方面,芯片展现出优异的光学指标:光波导传输损耗低于0.1 dB/cm,端面耦合损耗低于0.25 dB/face。以标准4芯光波导芯片(127 μm转40 μm间距)为例,其纤到纤插入损耗最低可控制在0.5 dB以内,同时保持良好的通道一致性与稳定的耦合性能,可满足800G、1.6T等高速光互连系统对低损耗传输的严格要求。

深光谷科技3D光波导关键性能指标
在制造能力方面,公司已于2025年8月建成玻璃基3D光波导芯片专用产线,采用自研飞秒激光直写设备与高精度自动耦合测试系统,实现高效率加工与稳定品质控制。单根波导加工效率可达秒量级,在保证性能一致性的同时具备良好的规模化生产能力,为数据中心与CPO系统的大规模部署提供可靠的产业化支撑。
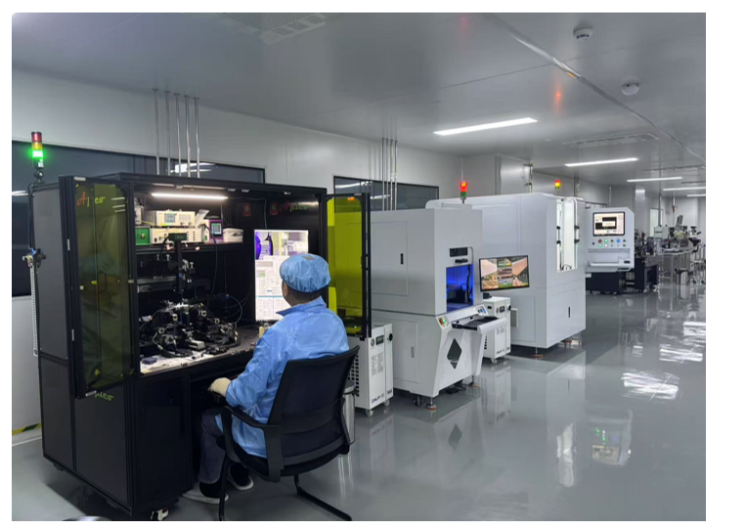
深光谷科技3D光波导芯片产线
现场重磅:产业链协同成果首秀,3D波导联合样品亮相
目前,公司正积极推进产业链协同,与下游无源器件厂商的合作持续深入,并已取得阶段性成果。在本届OFC 2026展会上,我们将首次联合产业链合作伙伴,现场展示基于3D光波导技术的最新联合样品:
✨ MT+MCF FIFO based on 3D Waveguide ✨

该联合样品集成了多方技术优势,体现了从芯片设计、3D光波导加工到无源器件封装的全链条协同能力。基于3D光波导芯片,该方案实现了硅光芯片到多芯光纤MT插芯之间的高效扇入/扇出(FIFO)光连接,完美适配800G/1.6T/3.2T多芯光模块需求,为下一代高密度光互连提供完整的芯片-器件级解决方案。
展会期间,我们的技术团队将携带这一联合样品及全系列3D光波导产品亮相展位,诚邀光模块厂商、光纤厂商、无源器件厂商、数据中心运营商及产业伙伴莅临交流,共同探讨高速光互连技术的发展与合作机遇。
这一联合样品集成了多方技术优势,代表着从芯片设计、波导加工到无源封装的全产业链协同能力。它基于3D光波导芯片,实现了多芯光纤(MCF)与MT插芯的高效扇入扇出(FIFO),为高密度光互联提供了完整的器件级解决方案。
二、先进封装服务
浙江岭芯光电科技有限公司(简称“岭芯光电”)是深圳市深光谷科技有限公司全资子公司,专注于玻璃基TGV与CPO(光电共封装)前沿技术的研发与制造。公司坐落于浙江温岭,拥有5000平方米的现代化生产基地,其中核心区域为2000平方米的高标准无尘车间,具备从晶圆级封装到模块组装的全流程精密制造能力。
核心封装能力
依托先进的玻璃基TGV工艺,岭芯光电突破了传统封装的带宽与功耗瓶颈:
● 高密度互连:利用玻璃基板优异的高频特性,实现微米级通孔互联,支持2.5D/3D堆叠封装。
● 超低损耗传输:专为AI算力与超算中心设计,完美适配800G至3.2T的高速光互连需求,显著降低信号延迟与能耗。
● 光电共封装(CPO):具备将硅光芯片(PIC)与电芯片(EIC)进行高精度共封装的核心能力,提供高集成度、高可靠性的光引擎解决方案。
最新产品亮相(OFC展会)-先进封装
在即将到来的OFC(光纤通讯展览会)上,岭芯光电将重磅展出ELSFP,展示利用先进封装而实现了光源的高效耦合。ELSFP为下一代数据中心光互连提供“即插即用”的独立光源,解决CPO架构下的散热与维护难题,提供高功率、高稳定性的方案。

ELS模块化产品实物图
3月17日-19日,洛杉矶会展中心,期待与您相见!

深圳市深光谷科技有限公司(以下简称“深光谷”)与广东亿源通科技股份有限公司(以下简称“亿源通”)正式达成深度战略合作,联合推出基于3D光波导技术的多芯MT-FIFO组件方案。该方案通过三维光波导结构实现硅光芯片与多芯光纤MT接口之间的高密度光路转换,在保证低损耗与高一致性的同时提升集成度,为下一代高速光模块和AI数据中心互连提供关键支撑

March 17-19, 2026. Los Angeles, California, United States Los Angeles Convention Center, WEST HALL This product is on display in the WEST HALL, Booth# : 4750